- 您现在的位置:首页 > 技术工艺 > 客户问题 > 胶粘剂 > 客户问题 > 胶粘剂
-
导热有机硅封装胶概述
作者:朱工 上传时间:2014-03-26 16:14:04 分享到:导热有机硅封装胶具有粘结温度低、热变形温度高、线膨胀系数和收缩率小、黏度小、适用周期长,可以与不同的基板连接,粘结设备简单,胶无毒或低毒等优点。但导热有机硅封装胶也有不足之处:如抗张强度与冲击强度低、粘结强度不佳;介电损耗和介电常数较高;与接触界面的热阻较高,导热性不高;如果使用在军用等特种设备上,耐热老化性也不是很好;价格偏高。这些都是目前限制有机硅封装胶应用的主要因素。
目前导热有机硅封装胶主要是采用有机硅树脂与高导热物质来作为基体和填料,由于它们的复合具有导热、防锈、耐寒、耐腐蚀、耐辐射、耐臭氧等性能而备受关注,但单纯的导热有机硅封装胶的力学性能不是很好,导热性也不佳。目前导热有机硅封装胶研发的重点和难点在于有机硅链上引入某些基团来改善其力学强度以及合成新型耐高温有机硅胶;开发新型高导热填料,在填充量较小时能保持封装材料的高导热率。

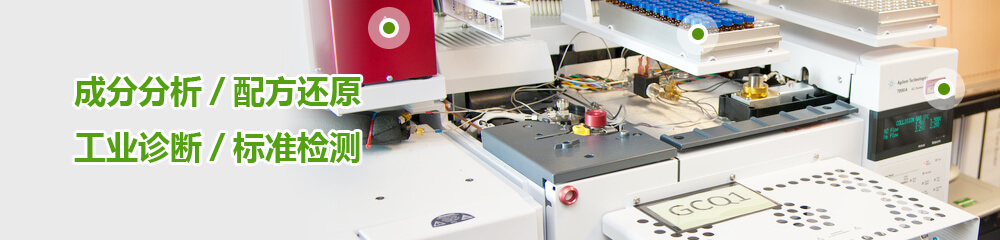
 扫描禾川官方微信,关注最新的配方技术!
扫描禾川官方微信,关注最新的配方技术!