- 您现在的位置:首页 > 技术工艺 > 分析案例 > 金属表面处理 > 分析案例 > 金属表面处理
-
化学镀铜配方分析|分析检测
作者:SystemMaster 上传时间:2014-03-25 11:36:19 分享到:化学镀 (Chemiealplating)又称自催化镀 (Autoeatalytieplating),是指在没有外加电流的条件下,利用溶液中的还原剂将金属离子沉积在具有催化活性的基体表面。从本质上讲,它发生的是一种自催化的氧化还原反应,又可译为不通电电镀或无电解电镀。是在基体表面上化学沉积形成金属或合金镀层的一种表面处理技术.
化学镀铜第一次工业应用开始于19 世纪50 年代中叶,此后化学镀铜技术被大量用于电子和涂装行业, 其中印刷电路板的工业生产一度成为规模最大的应用领域。化学镀铜技术继而被用于金属化工艺,在半导体电子行业等高技术领域扮演着越来越重要的角色,特别是近年来,超大规模集成电路由铝金属化发展为铜金属化工艺以来,化学镀铜技术更加受到关注.
禾川化学专业从事化学镀铜添加剂配方分析、成分分析、配方检测、成分检测;禾川化学是镀铜企业产品技术革新的风向标;禾川化学成功开发出新型化学镀铜配方技术;该化学镀铜镀层厚度均匀,无明显边缘效应,特别是对复杂形状的基体,在尖角或凹凸部位没有额外的沉积或沉积不足,在深孔、盲孔件、腔体件的内表面也能得到和外表面同样厚度的镀层,因而对尺寸精度要求高的零件进行化学镀铜特别有利;该镀层晶粒细、致密、空隙少,呈光亮或半光亮,比电镀层更加耐腐蚀;该镀铜技术无需电解设备及附件,工艺操作人员也无需带电操作,均可在所需部位镀出合乎要求的镀层。该镀铜技术广泛应用于电子、汽车、航空等行业.
二.化学镀铜
典型的镀液成分主要由无机盐和有机添加剂组成。无机盐包括CuCl2、CuSO4、氯离子,采用的主要有机添加剂包括促进剂(或称为光亮剂);抑制剂(表面活性剂,润湿剂,阻化剂)。
2.1.1铜盐
铜盐是化学镀铜的主盐,提供镀铜所需要的铜离子,可以使用CuSO4、CuC12、Cu(NO3)2、Cu(OH)2、(CH3COO)2Cu、酒石酸铜等二价铜盐;目前最常采用的铜盐为硫酸铜,化学镀铜溶液中铜盐的含量越高,镀速越快;但是当其含量继续增加达到某一定值后,镀速变化不再明显。铜盐浓度对于镀层性能的影响较小,然而铜盐中的杂质可能对镀层性质造成很大的影响,因此化学镀铜溶液中铜盐的纯度要求较高.
2.1.2络合剂
络合剂是化学镀液中的关键成分,络合剂一方面可使铜离子的极化增大,使所得的镀层结晶细致光亮,另一方面可使镀液稳定,防止铜离子在碱性条件下生成Cu(OH)2沉淀。常用的配位剂有酒石酸钾钠、柠檬酸钠、乙二胺四乙酸二钠、三乙醇胺、氨二乙酸等;酒石酸是最早使用的络合剂,特别适合于室温和低沉积速率时使用,也较易进行污水处理,但沉积速率低、镀液稳定性低且镀层韧性差限制了它的应用范围;乙二胺四乙酸(EDTA),作为络合剂,是因为该体系的镀铜液稳定性高、镀速快、镀层质量好;以三乙醇胺(TEA)作络合剂的化学镀铜,以一定比例配成的工作液有很高的镀速和稳定性,但是当三乙醇胺、三异丙醇胺用量超过一定值时,镀速会急剧减小,虽然EDTA的用量对镀速的影响不大,但其速率要比三乙醇胺小很多.
2.1.3还原剂
镀铜溶液中还原剂的作用是使铜配离子还原为金属铜,常见的还原剂有甲醛(HCHO)、乙二醛、乙醛酸、次磷酸盐、四丁基硼氢化铵二甲氨基硼烷、联氨、硼氢化钠、阱(N2H4)、氨基硼烷及其衍生物等。出于生产成本和操作工艺的考虑,目前工业上仍普遍使用甲醛作为化学镀铜溶液的还原剂。该溶液得到的铜膜电阻率低,沉积速率高,具有很好的应用价值。
乙醛酸在碱性溶液中发生Cannizzaro 副反应, 对于化学镀铜来说它属于副反应, 此反应会产生大量的草酸盐,不但消耗镀液中的还原剂,而且还缩短了镀液的使用寿命。1)用碱性更强的KOH来替代传统的NaOH 作为镀液pH的调节剂,因为在同一种溶液中,草酸钾的溶解度比草酸钠的溶解度要大。2)加入微量添加剂如甲醇、一级胺、二级胺、硅酸、硅酸盐、磷酸、磷酸盐、二氧化锗、钒酸、钒酸盐、锡酸及锡酸盐,用量为0. 0001 mol/ L 或以上,从而抑制Cannizzaro 副反应,减少由此反应所产生草酸根。
加入乙醇酸、乙酸、氨基乙酸、草酸、丁二酸、苹果酸、丙二酸、柠檬酸等,可加速乙醛酸的氧化反应。
2.1.4促进剂
促进剂,通常是含有硫或其它官能团的有机物,包括硫脲及其衍生物。促进剂的作用这类添加剂的主要作用是提高阴极电流密度和使镀层晶粒细化;同时促进剂还可以优先吸附在活性较高、生长速率快的晶面上,使得金属的吸附原子进入这些活性位置有困难,使这些晶面的生长速率下降,从而得到排列整齐的晶体,使镀层均匀。目前,通常使用SPS(聚二硫二丙烷磺酸钠)和MPSA(3-巯基丙烷磺酸钠)。
2.1.5抑制剂
抑制剂,其特征是在阴极表面上形成一层连续膜以阻止铜的沉积。抑制剂能够吸附在镀件的表面阻化或减少光亮剂和整平剂的扩散传递,而加大在刻槽口的吸附,达到整平效果。目前,最为常用的是PEG和PEG与氯离子的协同作用,氯离子的存在可以加强其吸附和阻化作用。PEG分子量越大,吸附能力越强,阻化作用越强,但是溶解性越差,扩散系数越小。
3.1化学镀铜参考配方一
成分
质量份
成分说明
硫酸铜
25~30
酒石酸钾钠
140~150
氢氧化钠
40~50
甲醛
18~20
乙二胺四醋酸
0.5~1.5
三乙醇胺
0~1
碳酸钠
8~10
二乙基二硫代氨基甲酸钠
0~1
去离子水
加至1L
以上参考配方数据都经过技术修改,仅供参考,关于电镀配方更多技术可以咨询我中心技术支持0512-82190860

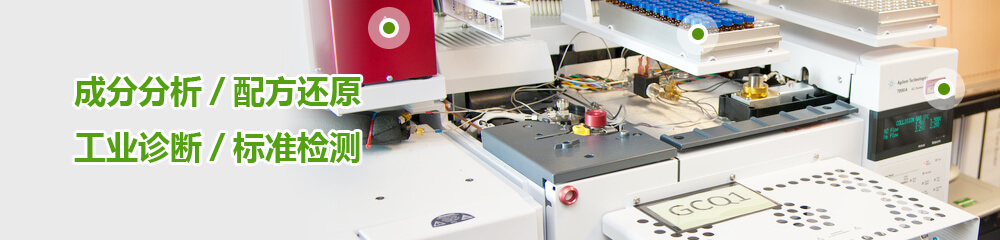
 扫描禾川官方微信,关注最新的配方技术!
扫描禾川官方微信,关注最新的配方技术!